原子力基盤技術データベースのメインページへ
作成: 1998/12/12 上岡 功
データ番号 :110004
シリコン表面のプラズマ酸化の初期における反応機構
目的 :半導体表面と酸素プラズマとの反応の機構の解明
研究実施機関名 :科学技術庁金属材料技術研究所第2研究グループ
応用分野 :半導体プロセス開発、原子炉材料
概要 :
シリコンのプラズマ酸化において、基板に直流バイアスをかけることによりプラズマ中の酸素化学種を選択的に基板に入射させ、表面の酸化膜成長をエリプソメーターを用いて実時間で観察することにより、イオン・原子・電子の酸化への寄与を調べた。その結果、酸化膜厚によって酸化に寄与する化学種が異なることが解り、特に、負バイアスをかけた時に、酸素原子の酸化への寄与を初めて観察することが出来た。
詳細説明 :
シリコンの酸化は、半導体プロセスのMOSFETの生成において、非常に重要な過程である。また、最近のLSIの微細化に伴い、ゲート酸化膜の薄膜化が進み、さらに良質な酸化膜を生成することが要求されており、そのためにはシリコンの酸化初期の反応機構を解明することが必要不可欠になっている。また、シリコンの酸素プラズマを使った酸化は、低温での成膜が可能なため、最近の環境を考えた半導体プロセスの省エネルギー化に繋がる技術として注目されている。さらに、核融合炉において、プラズマ中の酸素が炉壁へ影響を与えることから、酸素プラズマと材料表面の反応機構の解明は重要である。
本研究では、酸素プラズマ中で、シリコン基板に直流バイアスをかけ、酸素化学種をシリコン表面に選択的に入射させることにより、シリコンのプラズマ酸化初期において寄与している酸素化学種とその反応機構について、エリプソメーターを用い、速度論的に調べた。
プラズマ酸化実験は、超高真空チャンバー内 (到達真空度< 1×10-7 Pa )に、シリコン〔p-Si(111)〕基板を取り付け、ガス圧 1.3 Pa で dry 酸素を導入後、試料から約 1.5 m の距離に設置した RF (Radio Frequency)コイルにより放電を行い、酸素プラズマを生成することによって行った。また、基板には -60〜+60 Vの範囲のバイアス電位を直流電源により印加した。そして、プラズマ酸化中の酸化膜厚の変化は、エリプソメーターにより実時間でモニターした(時間分解能:1 s)。さらに、プラズマ特性をラングミュア・プローブを使って調べた。
図1は、それぞれのバイアス電位における偏光解析パラメーターΔの放電開始直後からの相対変化δΔ[δΔ(t) ≡ Δ(0)-Δ(t)]を表している。δΔの変化は極薄膜では膜厚の変化に直接反映する。この図より、いずれのバイアス印加においても、δΔは放電開始直後は急激に増加し、徐々に変化は緩やかになっている。δΔの時間変化は、負バイアスよりも正バイアスを印加した時の方が大きく、正バイアスでは電圧が大きくなると変化量も大きくなっていることが分かる。
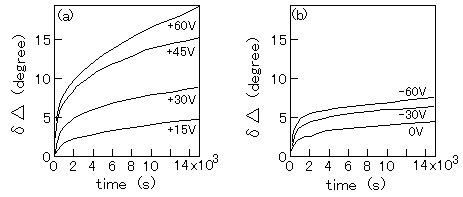
図1 Time dependence of δΔ(δΔ=Δ(0)-Δ(t)) measured by real-time ellipsometry at different sample biases. (a) positive bias, (b) zero and negative bias.(原論文2より引用)
図2はそれぞれの酸化時間におけるδΔの変化率(∂(δΔ)/∂t)の試料バイアス依存性を表している。本研究では、酸化速度は∂(δΔ)/∂tにより議論した。酸化速度はバイアス電圧に依存し、プラズマ酸化開始直後では、それが顕著に現れる。すなわち、放電開始直後は、酸化速度は+27 V 付近に極小を有し、正バイアス側と負バイアス側双方において増加している(図2a)。この結果から、放電開始直後は、正バイアス側は電子の表面吸着種の励起、負バイアス側は正イオンのシリコン表面との直接的な反応が酸化を律速することが解った。
また、図2から判るように、(a)→(b)→(c)と酸化時間が経過するにしたがって、酸化速度のバイアス依存性は小さくなる。これは、シリコン表面の酸化膜の成長により、シリコンとプラズマ中のイオンや原子との直接的な酸化反応が妨げられることを表している。長時間酸化後(〜15000 s)では、酸化速度のバイアス依存性は、正バイアス側は、放電開始直後と同様、バイアスの増加とともに酸化速度は増加する。一方、約+10 V 以下の負バイアス側では、酸化速度にバイアス依存性はなく一定である。これは、長時間酸化後は、正バイアス側は、負イオンの膜内の電位勾配による輸送過程が酸化を律速し、負バイアス側は、中性原子の膜内拡散が酸化を律速していることを示している。
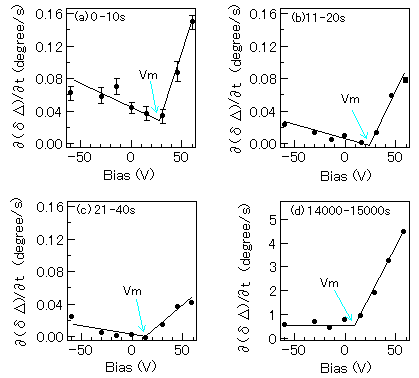
図2 Sample bias dependence of differential coefficient ∂(δΔ)/∂t at different plasma oxidation time. Scale in Y axis for (d) is magnified by 300 times compared with (a), (b) and (c). Vm is the bias of the minimum rate.(原論文2より引用)
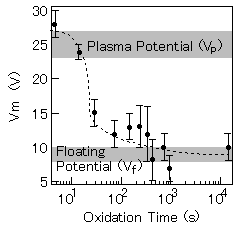
図3 The minimum point Vm as a function of the oxidation time. At Vm, ∂(δΔ)/∂t exhibitted a minimum for the short oxidation time and started to rise for the long time.(原論文2より引用)
また、プラズマ酸化速度は、バイアス依存性に極小値を有する(図2)。酸化速度の極小点あるいはバイアスを増加させ酸化速度が上昇し始めるバイアス Vm の時間変化を図3に示す。Vm は放電開始直後はプラズマ電位にほぼ一致する+27 V 付近である。 しかし、Vm は時間とともに小さくなり、長時間酸化後は浮遊電位とほぼ一致する+10 V 付近になる。これは、表面電位が放電開始直後はバイアス電圧に等しく、膜の成長とともに浮遊電位に近づいていくことを反映している。
コメント :
最近、MOSトランジスターのゲート酸化膜の生成方法として、酸素原子(ラジカル)を用いた成膜が注目されている。その利点として、反応活性であること、入射エネルギーがイオンなどに比べて小さいため基板への損傷が少ないことなどがある。また、低温で成膜が可能なため、省エネルギー化にもなる。現在、酸素ラジカルの生成方法は主に2つあり、1つ目は酸素プラズマを生成し、シリコン基板まで距離を置くことにより、イオンと電子を再結合させ、ラジカルを生成する方法、2つ目はオゾンを生成し、入射させ、オゾンがシリコン表面付近で解離吸着をする性質を利用して酸素ラジカルを生成する方法である。
本研究では、シリコン基板から約1.5m 離れたプラズマ源により酸化を行っている。ところが、円筒形の容器の径が小さくないため(約0.25m)、基板付近でもプラズマの性質は十分保っていた。しかし、プラズマ源から基板に到達するまでの間に、ある程度のイオンと電子が再結合を起こしている可能性は十分考えられる。本研究で、基板付近のプラズマの電子密度が低かったのは、その理由によると思われる。また、負バイアスを印加した時の酸素原子の寄与が明らかになったのは、プラズマ源付近よりも基板付近で高い密度の酸素原子が存在しているためである可能性も高い。その点を含め、本研究で行った、基板にバイアスをかけ、酸素プラズマ中の化学種を選択的に入射させた手法は、今後プラズマ酸化を制御する上で有用な技術であると思われる。
原論文1 Data source 1:
Oxidation rate and surface-potential variation of silicon during plasma oxidation
M. Kitajima, I. Kamioka, K. G. Nakamura and S. Hishita*
National Research Institute for Metals, 1-2-1 Sengen, Tsukuba, Ibaraki 305; *National Institute for Research in Inorganic Materials, 1-1 Namiki, Tsukuba, Ibaraki 305
Phys. Rev. B 53, 3393 (1996)
原論文2 Data source 2:
シリコンのプラズマ酸化における酸素イオンの効果
上岡 功、北島 正弘、河辺 隆也、中村 一隆、菱田 俊一*
金属材料技術研究所 〒305 つくば市千現1-2-1; *無機材質研究所 〒305 つくば市並木1-1
表面科学 16, 504 (1995)
キーワード:シリコン、プラズマ酸化、偏光解析、バイアス依存性、反応機構
silicon, plasma oxidation, ellipsometry, bias dependence, mechanism
分類コード:110101
原子力基盤技術データベースのメインページへ